IGBT(绝缘栅双极性晶体管)已经广泛应用于各种高功率电子设备中。为了深入了解这种关键器件,我们先来探讨其一的基本特性——静态特性。
1. 静态特性
1.1通态特性
IGBT的通态特性是指其在导通状态下的电性能。当IGBT的Gate极施加一定正压时,P-base区的少数载流子——电子,在Gate极氧化层下大量积聚,形成感生沟道,在N+区和N-drift间形成一个桥梁,完成两个N掺杂区的互联,IGBT的正面MOS结构导通;感生沟道产生后,给Collector-Emitter一个正向偏置,IGBT的纵向diode结构导通,至此整个IGBT器件导通。下图分别为平面栅型IGBT和沟槽型IGBT的沟道形成和导通电流流向示意图。
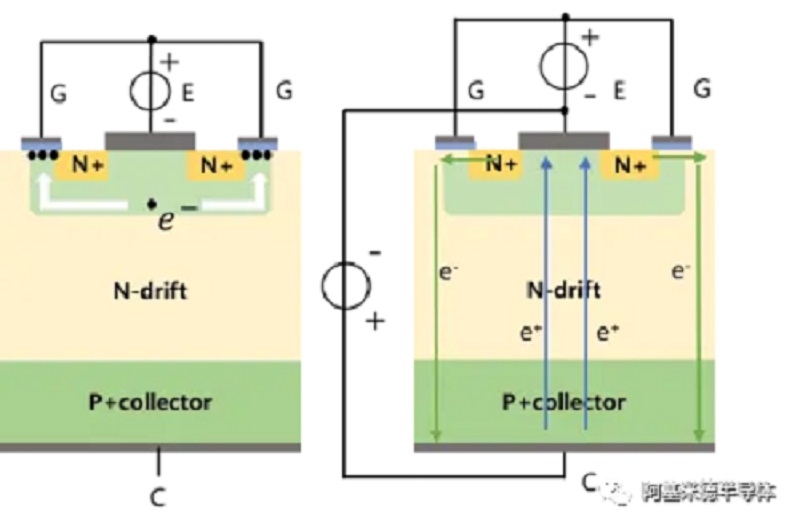
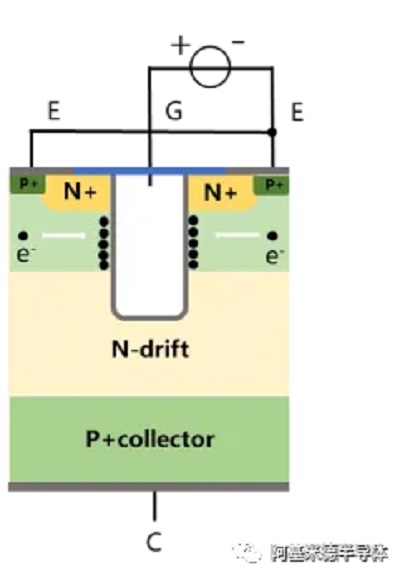
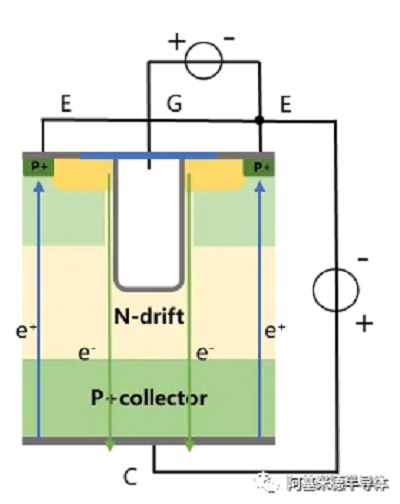
所以,IGBT在导通状态下可采用 pin 二极管和 MOSFET 串联等效模型来描述。
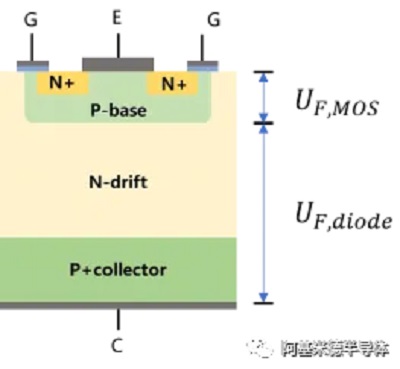
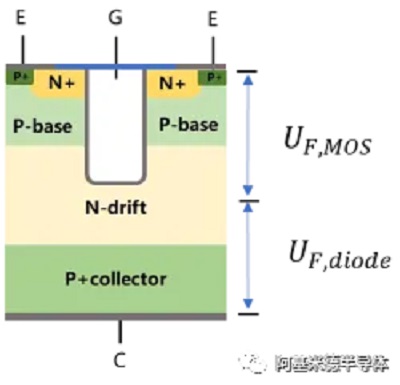
一般来讲,由于IGBT 在导通期间N-drift区会发生电导调制效应,故其N-drift区掺杂浓度比功率 MOSFET 要低得多,然而N-drift区的低掺杂也会导致在JEFT区产生一个高的压降。为了获得较低的饱和电压,提高 JEFT 区的掺杂浓度是一个有效的手段。因此,在实际器件设计中,为了获得低的饱和电压和最高的开关频率,优化JFET 区就显得十分重要了。
1.2 阻断特性
IGBT的阻断特性是指其在非导通状态下的电性能。当IGBT的控制极正向施加一定电压时,其工作于截止状态,不导通电流。在阻断状态下,IGBT可以承受相当高的反向电压,以及较低的反向漏电流。
1.2.1正向阻断
如下图所示,IGBT 工作在正向阻断模式下时,Collector上加正压,J1结正偏,J2结反偏,器件的阻断电压由反偏结J2来承担,因此 IGBT 具有正向阻断能力。但必须保证Gate-Emitter短路,以防止形成导电沟道。
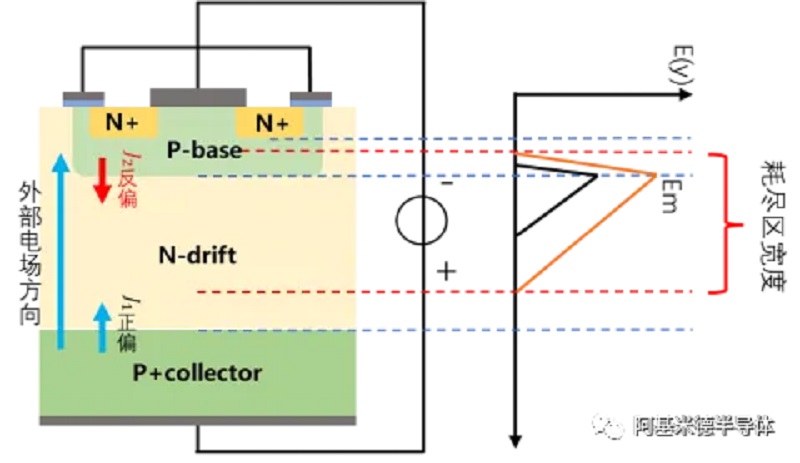
当正向电压较小时,NPT-IGBT的耗尽层的扩展宽度远小于其N-drift的厚度,随着外加正向电压的逐渐增大,耗尽层的不断扩展,只有当峰值电场强度等于雪崩击穿的临界电场强度时,IGBT 才会发生雪崩击穿,此时 IGBT的正向阻断能力由雪崩击穿特性来决定。

1.2.2 反向阻断
IGBT 工作在反向阻断模式下时,Collector上加负压,J1结反偏,J2结正偏,器件的阻断电压由反偏结J1来承担,其反向阻断电压主要由 J1结两侧的掺杂浓度和厚度决定。
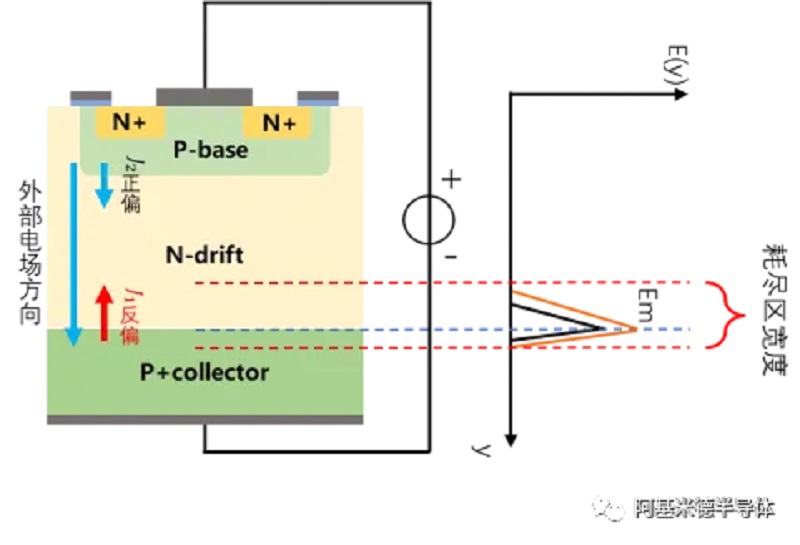
对于NPT-IGBT 而言,外加反向偏置电压,J1结反偏,N-drifth耗尽区扩展,J1结处峰值电场最高。但是由于现在的IGBT芯片背面一般都很薄,所以器件的反向耐压通常很小。

IGBT的静态特性对于电力电子应用至关重要。通过深入了解和优化IGBT的静态特性,我们可以提高开关效率、降低功耗,并确保系统的可靠性和稳定性。通过持续的研究和创新,我们可以进一步提升IGBT的静态特性,开发出更高性能、更高效率的IGBT产品,推动电力电子技术的发展和应用。
| 上一篇:IGBT双脉冲测试-探头延时校准篇 | 下一篇:SiC MOS器件结构及基本特性 |
安徽省合肥市高新区长宁大道789号5号楼



