一、引言
在功率半导体器件的发展历程中,FS-IGBT(Field Stop IGBT)的诞生与迭代深刻推动了功率器件性能的跨越式提升。该器件的核心创新在于引入了 FS 层(场截止层),结构如图1所示,能够在阻断状态下巧妙构建梯形电场分布,有效缩短漂移区的物理长度,同时搭配透明集电区技术优化阳极注入效率,最终实现了导通压降与关断损耗的双重突破,凭借这一卓越优势,FS-IGBT 迅速成为工业控制、新能源汽车、电力电子等领域商业化应用的主流选择。
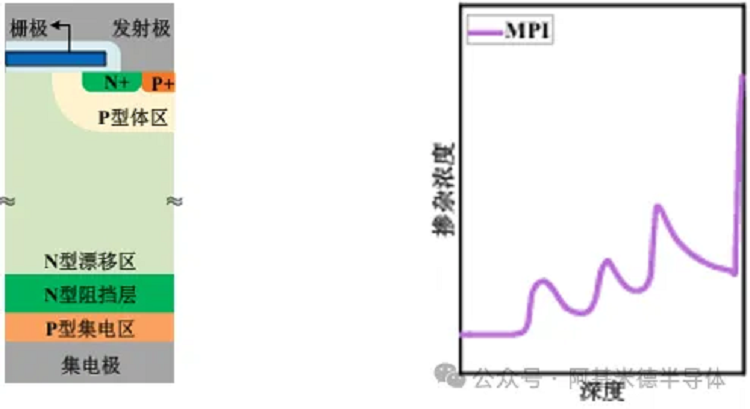
图1 FS-IGBT结构示意图 图2 MPI掺杂结构示意图
英飞凌公司于2016年,提出了使用多次质子注入(Multiple Proton Implantation,MPI)与低温退火形成三峰值的FS层与阻挡层的掺杂结构(图2)。通过该方案,可精准制备出具有三峰值分布的 FS 层与阻挡层复合结构,这一突破赋予了器件背面掺杂设计极高的灵活性与自由度,能够根据不同应用场景的性能需求定制化调整掺杂分布。此后,类似的多峰值质子注入层结构,以及结合磷注入的复合阻挡层演变方案,逐渐成为全球功率器件行业的主流设计趋势,引领着 FS-IGBT 技术的持续演进。
二、质子注入技术原理
质子注入之所以能实现 N 型导电区的精准构建,其核心机理源于氢原子独特的氢诱导施主特性。值得注意的是,这种导电特性并非氢原子本身直接赋予,而是氢原子在注入硅晶格后,与晶格中天然存在或注入过程中产生的空位等缺陷发生复杂相互作用,形成具有稳定施主性质的氢空位复合物。这些复合物在后续的高温退火工艺中能够保持结构稳定,通过向晶格释放自由电子,显著提高硅材料的电子浓度,从而使注入区域呈现稳定的 N 型导电性。
在实际工艺调控中,通过精准匹配氢注入能量、注入剂量,以及退火温度、退火时间等关键参数,技术人员可在 IGBT 背面精准定制出深度与浓度分布高度适配的 N 型缓冲层(即 FS 层),其最深注入深度可达 50μm(图3),完全满足不同功率等级器件的设计需求。这一精准调控过程能够有效优化器件内部的电场分布,不仅大幅提升器件的击穿电压,还能显著改善开关动态特性;而 FS 层的纵向延伸范围可通过灵活调整注入能量与退火工艺参数实现精准控制,其中退火温度与时间的变化会直接主导氢原子的扩散行为,进而影响氢相关施主轮廓的最终分布形态 —— 温度升高或时间延长时,氢原子会从注入峰值区域向晶圆表面扩散(图4),使施主轮廓呈现规律性扩展。
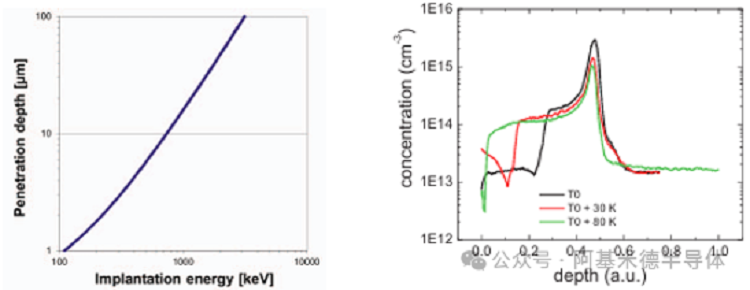
图3 注入能量对氢轮廓的影响 图4 退火温度对氢轮廓的影响
三、多重质子注入对器件静动态特性的影响
多重质子注入形成的 FS 层,其深度分布与峰值浓度配置,对 FS-IGBT 器件的静态特性与动态特性均具有决定性影响。基于英飞凌公司的相关研究数据,通过两组对比仿真实验可清晰揭示其内在规律:
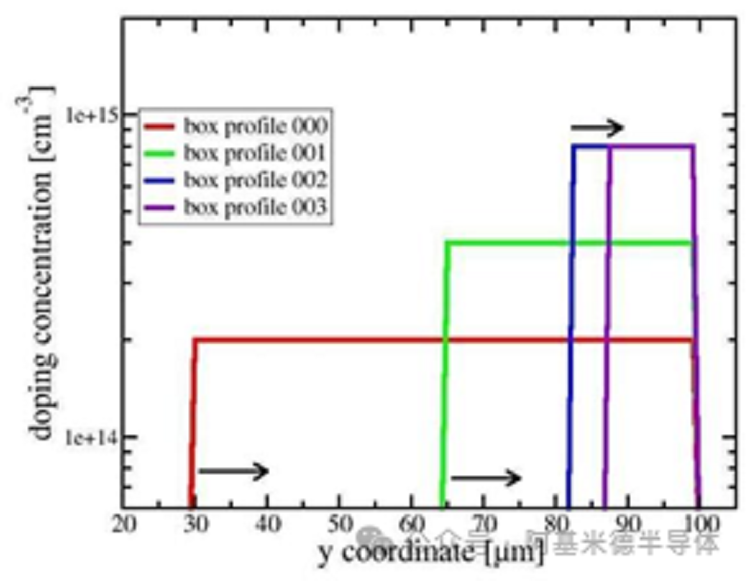 图5 箱型场截止掺杂分布曲线
图5 箱型场截止掺杂分布曲线
第一组为 FS 剂量相同、深度不同的工况,随着 FS 层深度由浅至深,器件饱和电压呈现轻微下降趋势,击穿电压则因漂移区有效宽度缩减而有所减小,同时开通损耗与关断损耗均有所上升(关断损耗增大源于拖尾电流增加),但器件的关断软度得到明显改善;
第二组为 FS 峰值浓度相同、深度不同的工况,随着 FS 层深度增加,饱和电压轻微上升,而击穿电压因深层缓冲层降低了 PNP 晶体管的电流增益 αPNP 而显著提升,开通损耗同样增大、电流变化率(di/dt)减小,关断损耗则明显降低,拖尾特性与关断软度无显著差异。
尤为关键的是,PNP 晶体管的电流增益 αPNP 是平衡器件短路鲁棒性与电场稳定性的核心参数:若 αPNP 取值过高,IGBT 在短路工况下易触发动态雪崩效应与热失控现象,最终导致器件闩锁失效;若 αPNP 取值过低,阴极流向阳极的电子会在器件内部形成负空间电荷,而背面发射极注入至空间电荷区的空穴数量不足以抵消电子电流的作用,将导致场截止区电场强度急剧升高,严重威胁器件可靠性。
多重质子注入构建的缓冲层,其峰值浓度应随结深由浅至深呈现梯度递减分布。这一设计中,三个峰值各司其职、协同发力:最浅的峰值主要承担控制 IGBT 阻断电压与漏电流的核心作用,保障器件在高压工况下的稳定阻断能力;中间的峰值专注于精准调节内部 PNP 晶体管的增益系数 αPNP,实现短路鲁棒性与电场稳定性的完美平衡;最深的峰值则致力于优化器件的关断软度,有效抑制关断过程中的电压尖峰与振荡,最终实现 FS-IGBT 器件综合性能的最优化,为各类高端功率电子应用提供可靠支撑。

图6 击穿电压仿真结果 图7 导通压降仿真结果

图8 开通损耗仿真结果 图9 关断损耗仿真结果
[1] Felsl, H. P. , F. J. Niedemostheide , and H. J. Schulze . "IGBT field-stop design for good short circuit ruggedness and a better trade-off with respect to static and dynamic switching characteristics." (2017):143-146.
| 上一篇:算力巅峰之下,阿基米德半导体如何重.. | 下一篇:科技打头阵:阿基米德半导体“Diamo.. |
安徽省合肥市高新区长宁大道789号5号楼



