(一) 引言
近年来,随着电气性能的不断提升,IGBT器件的可靠性得到越来越多的关注,对IGBT可靠性的要求越来越高,特别是在电动汽车和混合动力汽车等汽车应用中。其中,器件的雪崩击穿鲁棒性是可靠运行的强制性要求之一。
对于IGBT的雪崩击穿可靠性而言,研究成果表明大多数IGBT器件的失效是由于能量过大导致局部过热,进而导致器件失效。近年来,有学者进一步研究发现,IGBT自身存在一定的击穿负阻特性,是IGBT 器件雪崩击穿可靠性差的主要原因。在这里主要对元胞区域的击穿负阻特性进行简单的介绍。
(二) 纤维电流
元胞区域出现击穿现象,常见于某一局部位置出现热烧毁,这是因为电流集中于某一个元胞,在电流集中效应的作用下,该点温度不断升高,最后造成局部热失效现象。在相同且均匀的元胞区出现的不均匀电流称为纤维电流,纤维电流的出现主要是由于元胞结构在工艺波动性的影响下导致结构的不均匀性造成的。
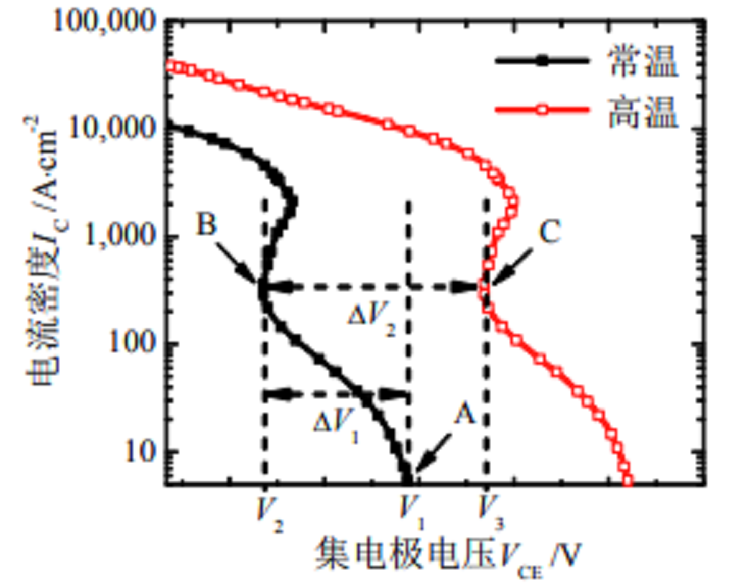
图1 理想元胞结构阻断 I-V 曲线的温度特性
如上图1所示为理想元胞结构阻断I-V曲线的温度特性,通过分析该理想曲线,可以了解有效的纤维电流转移路径和温升转移的途径,主要分为下列几个阶段:
a. A->B:击穿电流密度增大,元胞击穿电压减小,此时其余元胞击穿电压不变,电流持续集中于该元胞,电压持续减小,曲线从A点转移至B点。电压从A点变成B点的电压差记为△V1。
b. B->C:电流持续集中,元胞温度上升,由于IGBT击穿电压呈现正温度系数,元胞的击穿电压也迅速上升,曲线从B点转移至C点。电压从B点变成C点的电压差记为△V2。
c. C->A:第一次出现电流集中的区域成为整个元胞区电压最高的区域,在电压差的作用下可以向其他低温的低压元胞转移,即从C点状态转变为A点状态。类似的,IGBT体内元胞呈现交替温度上升的现象。
温升引起的电压(△V2)上升是有限的,因此要使得纤维电流在元胞区能够有效转移,应该尽可能的优化△V1,只要△V1尽可能的小,那么温升引起的上升电压就可以使得纤维电流转移,从而提升器件雪崩击穿鲁棒性。
(三) 击穿负阻特性
要优化△V1,需要先分析其形成机理。如下图2所示,击穿I-V曲线存在三个明显不同的变化阶段,即第一负阻区(NDR1)、正阻区(PDR)、第二负阻区(NDR2)。
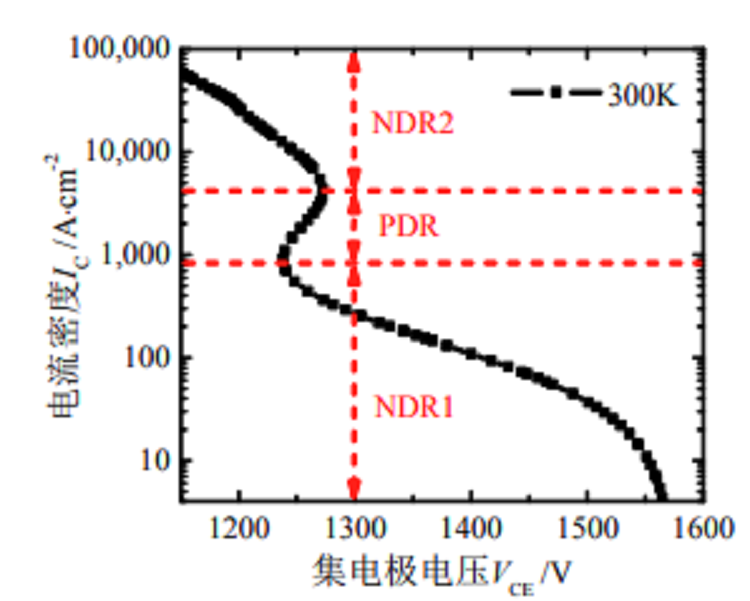
图2 阻断 I-V 曲线分阶段示意图
第一负阻区(NDR1):电流密度上升,漂移区的可移动电荷浓度达到漂移区固定电荷浓度的数量级,集电极电流中空穴电流大于电子电流,从而漂移区的净可移动电荷表现为正电性,会增大漂移区的电场斜率,而电场斜率的增大会导致集电极电压 VCE减小,表现出负阻特性。
正阻区(PDR):随着电流密度的持续增大,αPNP开始减小,从而集电极电流中空穴电流的成分相对于电子电流的成分开始减少,漂移区的净可移动电荷表现为负电性,会减小漂移区的电场斜率,而电场斜率的减小会使得集电极电压 VCE增大,表现出正阻特性。
第二负阻区(NDR2):当电场强度达到N-外延层/N+缓冲层之间结的临界电场时,会造成雪崩击穿,引发漂移区双边注入效应,此时外延层两边雪崩倍增产生的载流子浓度远远大于漂移区的原有载流子浓度,且漂移区中部的电场强度显著降低,导致集电极电压 VCE减小,表现出极强的负阻特性,形成阻断I-V曲线的NDR2阶段。最后,当电流密度更大一些,触发器件严重的闩锁效应,VCE进一步突降。
通过上述对常温下阻断 I-V 曲线的分析可以看出,要实现常温下阻断 I-V 曲线中的△V1尽可能小,就需要对其 NDR1 阶段的载流子分布以及电场分布情况进行优化,主要涉及到αPNP相关的结构参数。
注:本文图片和相关引用资料来源于下列文章
1. Zhuo Yang,“1200V FS-IGBT with electric field modulation layer to improve trade-off between avalanche ruggedness and on-state voltage drop,”in Electronics Letters.
2. K Endo, S Nagamine, W Saito, et al. Direct photo emission motion observation of current filaments in the IGBT under avalanche breakdown condition[C].
3. 杨卓.低损耗IGBT设计及可靠性研究[D].
| 上一篇:恭喜阿基米德半导体实习生陈安宁斩获.. | 下一篇:逆导型RC-IGBT设计简介及优化方向 |
安徽省合肥市高新区长宁大道789号5号楼



