一、引言
在绝缘栅双极型晶体管中,引入场截止(FS)层旨在显著减小漂移区的厚度,同时保持器件的阻断能力,从而改善通态压降与关断损耗之间的权衡。FS层通常通过在器件背面注入轻掺杂的N型杂质来形成,氢(H)注入和磷(P)注入是两种关键的技术手段。这两种元素在质量、投影范围、扩散行为和激活特性方面的内在差异决定了不同的注入工艺设计以及所形成的FS层特性,进而对IGBT的电气性能产生根本不同的影响。本文从原子层级来解释氢掺杂和磷掺杂之间显著的差异性。
二、磷和氢掺杂第一性原理机理分析
(一) 磷掺杂态密度和分子结构

图1 态密度和原子结构:(a)本征硅;(b)磷掺杂硅
如图1当磷原子掺杂到硅材料中时,磷原子作为五价杂质替代了硅原子的位置,导致费米能级向靠近导带底部的方向移动。这标志着N型掺杂的形成,磷掺杂以替位掺杂的方式进入硅中,其电导率特征与实际磷掺杂硅的N型电导率一致。磷原子的掺入增加了材料中的可移动电子数量,使得费米能级移向导带底部。这种变化意味着在导带底部附近出现了额外的电子态,这些电子将很容易从价带跃迁至导带,形成导电的自由电子。
(二) 氢掺杂态密度和分子结构
当氢作为间隙杂质引入时,它位于晶格间隙位置,不与任何硅原子成键。此构型会在禁带中引入深能级,导致载流子散射加剧,电导特性难以控制。当氢与一个硅原子形成共价键时,如图 2(b)和(c)所示,氢仍表现为掺杂态。此时氢可提供少量电子,呈现微弱的N型掺杂特性,但禁带中仍存在明显的杂质能级,对载流子输运仍有一定影响。最具技术意义的是如图2(d)所示的桥位掺杂构型,即氢原子位于两个硅原子之间,与二者同时成键。该构型增强了掺杂效果:氢原子为电子输运提供了更有利的路径,促使费米能级向导带底移动,表现出明显的N型掺杂特征。在此状态下,氢不仅增加了自由电子浓度,也通过形成新的局域电子态,优化了载流子迁移路径,从而有效提升了硅材料的电导率与载流子迁移率。
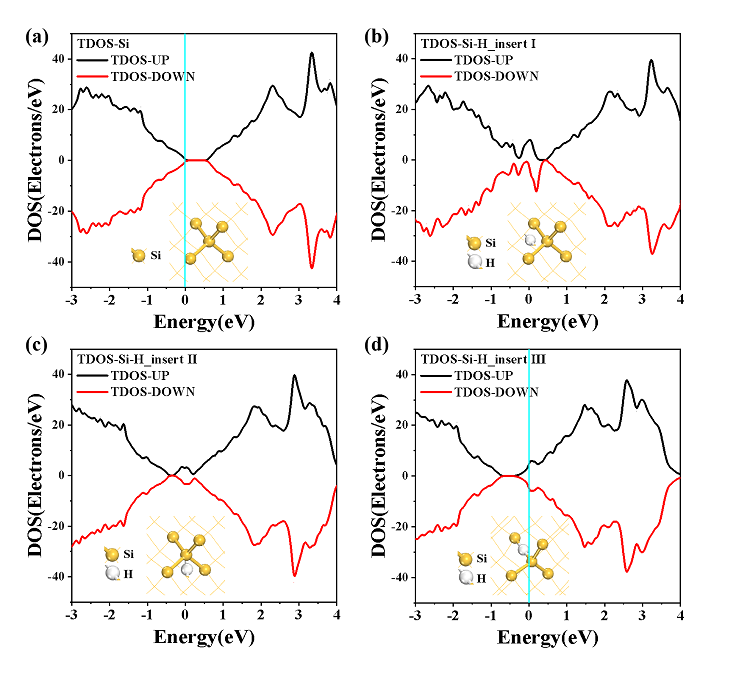
图 2 态密度和原子结构:(a)本征硅;(b)氢掺杂硅;(c)氢掺杂硅Ⅰ型;(d)氢掺杂硅Ⅱ型
(三) 缺陷硅中磷和氢掺杂态密度和分子结构
硅晶体中的结构缺陷(如空位、间隙原子或晶界)会在禁带中引入深能级缺陷态。这些缺陷态不仅成为载流子的复合中心,导致漏电流增加、器件可靠性下降,还会引起费米能级钉扎,劣化材料的导电特性与载流子迁移率。氢掺杂为缺陷调控提供了独特的途径。如图3(b)和(c)所示,氢原子可主动迁移至缺陷位点,并与悬挂键或未饱和硅原子发生相互作用。通过形成稳定的Si‑H键,氢有效中和了缺陷处的未配对电子,从而消除禁带中的缺陷能级。相较于氢掺杂,磷掺杂在处理硅晶体缺陷方面存在明显局限性。作为典型的五价施主杂质,磷原子虽能引入额外自由电子,提升材料的N型导电性,但其原子尺寸与电子结构与缺陷位点的化学环境不匹配,难以与缺陷周围的硅原子形成稳定的饱和键合。因此,磷掺杂无法有效钝化缺陷处的未配对电子,导致禁带中的缺陷能级得以保留,材料仍受载流子复合、迁移率下降及漏电流增大等问题困扰,甚至可能因掺杂引起的晶格应力而加剧缺陷相关的电学退化。

图3 态密度和原子结构:(a)缺陷硅;(b)氢掺杂缺陷硅;(c)磷掺杂缺陷硅;(d)先磷掺杂后氢掺杂缺陷硅
若在磷掺杂基础上引入氢掺杂,如图3(d)所示,则可形成优势互补的协同调控机制。在此双重掺杂工艺中,氢原子凭借其高迁移性与反应活性,能够选择性钝化磷掺杂未能处理的缺陷态,修复禁带中的缺陷能级,缓解能带弯曲,从而降低载流子散射与复合概率。这一协同作用不仅保留了磷掺杂的高载流子浓度优势,同时通过氢的缺陷钝化效应,大幅提升材料的载流子迁移率与体电导率,实现电学性能的全面优化。
| 上一篇:IGBT短路耐受性设计(二)——芯片短.. | 下一篇:IGBT寄生电容对开关性能的影响 |
安徽省合肥市高新区长宁大道789号5号楼



